查看引用/信息源請點擊:中國AI網(wǎng)
為適用于下一代顯示器和新興光子技術(shù)的低功耗Micro LED平臺開辟了道路
(中國AI網(wǎng) 2025年10月30日)氮化銦鎵量子阱微米級與納米級LED在下一代增強(qiáng)現(xiàn)實/虛擬現(xiàn)實顯示領(lǐng)域具有廣闊前景。然而,納米尺度化面臨著顯著挑戰(zhàn),包括增強(qiáng)的非輻射表面復(fù)合、缺陷和/或位錯相關(guān)的發(fā)光性能退化以及納米級像素接觸形成等問題。
在一項研究中,加拿大國立科學(xué)研究所,波蘭科學(xué)院,孟加拉國工程技術(shù)大學(xué),美國密西根大學(xué)團(tuán)隊通過采用等離子輔助分子束外延(PAMBE)技術(shù)在極低位錯密度單晶氮化鎵(GaN)襯底生長全氮化銦鎵量子阱/勢壘異質(zhì)結(jié)構(gòu),并結(jié)合自上而下納米加工技術(shù),成功制備出應(yīng)變工程化的納米級藍(lán)光LED像素單元。
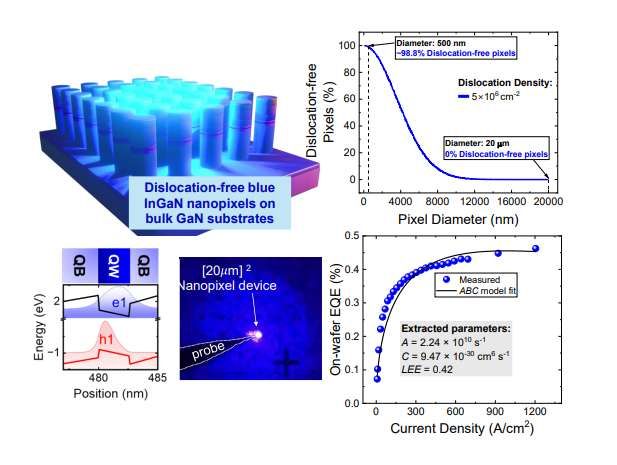
利用原子層沉積(ALD)技術(shù)沉積三氧化二鋁(Al?O?)進(jìn)行側(cè)壁鈍化,可以實現(xiàn)優(yōu)異的二極管特性,包括高整流比和極低的反向漏電流。蒙特卡洛分析表明450納米像素單元中完全無位錯有源區(qū)的良率接近100%。電致發(fā)光測試顯示明亮的藍(lán)光發(fā)射,其峰值外量子效率(EQE)達(dá)0.46%。泊松-薛定諤模擬表明量子阱中存在部分應(yīng)變弛豫,有效緩解了量子限制斯塔克效應(yīng)(QCSE)。
時域有限差分(FDTD)模擬進(jìn)一步證實:與平面設(shè)計相比,納米級結(jié)構(gòu)可使光提取效率提升40%以上,且所述增強(qiáng)效應(yīng)與襯底材料無關(guān)。相關(guān)研究成果為制備適用于先進(jìn)顯示和光子系統(tǒng)的無位錯、高亮度InGaN Micro LED陣列提供了可擴(kuò)展的解決方案。
基于氮化銦鎵量子阱的光源在現(xiàn)代光電子學(xué)發(fā)展中至關(guān)重要,尤其適用于增強(qiáng)現(xiàn)實與虛擬現(xiàn)實近眼顯示前沿技術(shù)。這類應(yīng)用需要具備微米/納米級像素尺寸的高像素密度、具有千兆赫茲調(diào)制帶寬的快速響應(yīng)時間以及超過103 cd/m2的卓越亮度。另外,科研界正大力開發(fā)基于氮化銦鎵量子阱發(fā)射器的全彩微顯示技術(shù)。
微納尺度LED存在固有挑戰(zhàn),其增加的表面體積比會加劇側(cè)壁的非輻射肖克利-里德-霍爾(SRH)復(fù)合。不過,三星已經(jīng)通過溶膠-凝膠介質(zhì)側(cè)壁鈍化技術(shù)實現(xiàn)了突破,制備出峰值外量子效率(EQE)達(dá)20.2%的納米級藍(lán)光LED。然而,由于”綠光缺口”現(xiàn)象,即綠光-紅光光譜范圍內(nèi)內(nèi)量子效率(IQE)顯著下降,迄今為止實現(xiàn)氮化銦鎵量子阱高效長波長發(fā)射(綠光-紅光)依然面臨巨大挑戰(zhàn)。
綠光缺口主要源于綠光與紅光發(fā)射所需的高銦含量,這引發(fā)了嚴(yán)重的材料學(xué)問題:InN與GaN之間11%的晶格失配導(dǎo)致量子阱區(qū)域產(chǎn)生強(qiáng)壓應(yīng)變,加劇了量子限制斯塔克效應(yīng)(QCSE),造成電子與空穴波函數(shù)空間分離,從而降低輻射復(fù)合效率。另外,高銦摻入會導(dǎo)致缺陷形成、相分離和富銦團(tuán)簇增多,進(jìn)一步惡化光電器件性能。
在商用c面藍(lán)寶石襯底上生長的GaN模板通常存在10?至10? cm?2的高位錯密度(TDD),而InGaN異質(zhì)結(jié)構(gòu)正是在此基礎(chǔ)上生長,所以使得問題進(jìn)一步惡化。這些位錯作為非輻射復(fù)合中心(NRCs)并阻礙銦的均勻摻入,導(dǎo)致難以實現(xiàn)穩(wěn)定高效的綠光與紅光發(fā)射。另外,在藍(lán)寶石襯底GaN模板上生長的InGaN異質(zhì)結(jié)構(gòu)常呈現(xiàn)高密度V形坑,相關(guān)缺陷會影響載流子復(fù)合動力學(xué)并導(dǎo)致發(fā)光性能的不均勻性。
為克服上述關(guān)鍵挑戰(zhàn),業(yè)界已經(jīng)探索了多種替代外延策略,目標(biāo)是降低位錯密度與V形坑相關(guān)缺陷,并解決綠光缺口問題。一種有前景的方案是自下而上生長三維納米結(jié)構(gòu),其高表面積體積比有助于側(cè)壁的有效應(yīng)變弛豫,從而減輕QCSE并改善銦摻入。然而,此類自下而上生長的納米線異質(zhì)結(jié)構(gòu)常存在結(jié)構(gòu)形貌不均勻和載流子復(fù)合壽命差異等問題,特別是在刻面頂部表面會出現(xiàn)銦摻入不均。
最近的研究表明:對平面LED進(jìn)行生長后自上而下納米加工,可制備出90%無位錯的LED,同時保持與平面器件相當(dāng)?shù)腎QE。同時,先前研究證實納米結(jié)構(gòu)可緩解InGaN量子阱中的壓應(yīng)變并增強(qiáng)輻射復(fù)合效率,但這些研究多聚焦于通過金屬有機(jī)化學(xué)氣相沉積(MOCVD)生長的GaN勢壘InGaN量子阱。
在一項新研究中,加拿大國立科學(xué)研究所,波蘭科學(xué)院,孟加拉國工程技術(shù)大學(xué),美國密西根大學(xué)團(tuán)隊提出了一種獨特混合策略:結(jié)合單晶GaN襯底上的等離子輔助分子束外延生長與后續(xù)自上而下納米加工技術(shù)處理InGaN異質(zhì)結(jié)構(gòu)。
通過將此法應(yīng)用于PAMBE生長的InGaN量子阱/勢壘LED異質(zhì)結(jié)構(gòu),他們解決了制約高效長波長發(fā)射與均勻器件性能的核心難題——位錯誘導(dǎo)漏電流路徑和V形坑驅(qū)動的銦分布不均。
實驗證明所提出納米LED表現(xiàn)出優(yōu)異的二極管整流特性和光輸出特性,這歸因于納米像素結(jié)構(gòu)帶來的改進(jìn)電流傳輸、增強(qiáng)載流子注入和提升光提取效率。器件可在高注入水平下維持最大EQE,實現(xiàn)高功率運行,而這對近眼顯示領(lǐng)域的節(jié)能Micro LED應(yīng)用至關(guān)重要。
研究中采用PAMBE技術(shù)在c面(0001)Ga極性n型GaN體晶(位錯密度低至~10? cm?2)上生長了藍(lán)光發(fā)射InGaN單量子阱與InGaN勢壘LED結(jié)構(gòu)。高質(zhì)量InGaN層通過高活性氮流量射頻等離子體源生長2。完整的PAMBE生長LED外延結(jié)構(gòu)如圖1(a)所示:包含450 nm n型In?.??Ga?.??N:Si層、2.6 nm In?.???Ga?.???N單量子阱層(嵌入30 nm和20 nm In?.???Ga?.???N勢壘層)、20 nm p型Al?.???Ga?.???N:Mg電子阻擋層、200 nm厚p型GaN:Mg層、40 nm p型In?.???Ga?.???N:Mg層,以及最終5 nm p型In?.???Ga?.???N:Mg?接觸層。

圖1(d)展示了0V偏壓平衡條件下該結(jié)構(gòu)的能帶圖,顯示出由自發(fā)和壓電極化效應(yīng)產(chǎn)生的內(nèi)建電場。模擬采用SiLENSe軟件包的一維漂移擴(kuò)散模型完成。
為制備納米LED陣列,采用電子束光刻(EBL)對平面LED結(jié)構(gòu)進(jìn)行圖形化,創(chuàng)建直徑約450 nm、像素間距700 nm的超密圓形像素陣列。陣列以[20×20] μm2方晶格排列。隨后通過電子束蒸發(fā)沉積80 nm鎳作為刻蝕掩模,采用優(yōu)化Cl?/Ar氣流的氯基感應(yīng)耦合反應(yīng)離子刻蝕(ICP-RIE)工藝實現(xiàn)納米像素成型。
圖1(c)顯示ICP-RIE刻蝕后納米像素陣列的掃描電鏡(SEM)圖像,顯示側(cè)壁呈錐形光滑結(jié)構(gòu),但通常存在高密度等離子體誘導(dǎo)缺陷。隨后使用80℃緩沖氫氧化鉀(KOH)溶液對納米像素陣列進(jìn)行濕法刻蝕,有效去除等離子體誘導(dǎo)的非晶側(cè)壁。
圖1(d)展示濕法刻蝕后的SEM圖像。為最小化側(cè)壁漏電流3?并有效鈍化剩余懸掛鍵,采用原子層沉積(ALD)技術(shù)制備60 nm三氧化二鋁(Al?O?)保形覆蓋納米像素陣列。采用旋涂玻璃(SOG)進(jìn)行平面化處理,隨后結(jié)合干法/濕法刻蝕技術(shù)回蝕Al?O?和SOG層:使用CF?基ICP-RIE工藝去除SOG,采用緩沖四甲基氫氧化銨(TMAH)溶液刻蝕ALD-Al?O?以暴露納米像素陣列頂部的p型InGaN接觸層。
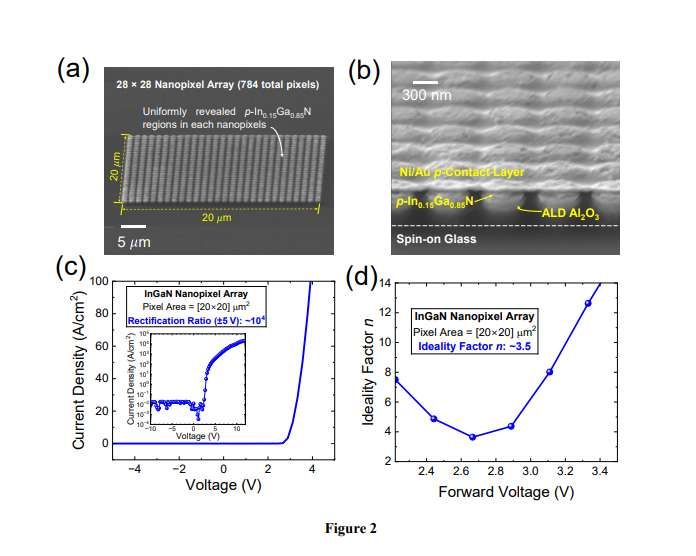
圖2(a)展示高倍SEM圖像。通過緩沖氫氟酸(HF)濕法刻蝕定義n接觸開口,選擇性去除SOG和Al?O?層。最后采用標(biāo)準(zhǔn)光刻工藝定義[20×20 μm]2器件區(qū)域以實現(xiàn)納米像素陣列并行尋址,電子束蒸發(fā)沉積20 nm/40 nm Ni/Au金屬堆棧形成p接觸,20 nm/20 nm Ti/Au堆棧作為n接觸,在N?氛圍中500℃進(jìn)行5分鐘接觸退火。圖2(b)顯示InGaN納米像素陣列器件堆棧的70°傾斜視角SEM圖像。
相關(guān)論文:InGaN Nanopixel Arrays on Single Crystal GaN Substrate
https://arxiv.org/pdf/2506.11408
總之,團(tuán)隊通過在GaN體襯底上采用自上而下納米加工技術(shù),成功演示了無位錯InGaN應(yīng)變弛豫納米像素LED。低位錯密度襯底與原子層沉積Al?O?介質(zhì)側(cè)壁鈍化的結(jié)合確保了卓越的材料質(zhì)量,實現(xiàn)了超低漏電流和優(yōu)異的二極管整流特性。器件在約1200 A/cm2的高注入電流密度下表現(xiàn)出明亮的電致發(fā)光,峰值EQE達(dá)0.46%,凸顯了其在高亮度、高電流密度應(yīng)用中的潛力。
泊松-薛定諤模擬表明納米像素量子阱幾何結(jié)構(gòu)中的應(yīng)變弛豫部分抑制了量子限制斯塔克效應(yīng),F(xiàn)DTD模擬則顯示在藍(lán)光光譜區(qū)域納米像素陣列的光提取效率較平面結(jié)構(gòu)提升約40%。相關(guān)發(fā)現(xiàn)強(qiáng)調(diào)了納米像素工程技術(shù)在克服尺度化挑戰(zhàn)方面的有效性,為適用于下一代顯示器和新興光子技術(shù)的低功耗Micro LED平臺開辟了道路。